

回流焊(Reflow Soldering)也叫再流焊,是指通過重新熔化預先放置的焊料而形成焊點,在焊接過程中不再添加任何額外焊料的一種焊接方法。早期預置的是片狀和圈狀焊料,隨著片式元器件的出現,膏狀焊料應運而生,并取代了其他形式的焊料,再流焊技術成為SMT的主流工藝。
溫度曲線定義
再流焊的本質就是“熱加工”,其工藝的核心就是溫度曲線設計。溫度曲線是指工藝人員根據所需要焊接的代表性封裝(元件)及焊膏特性制定的“溫度-時間”變化曲線。通過鏈條傳送PCB速度和不同溫區的溫度設置來實現。
把設置溫度放置在溫度曲線力中并連接就形成一條折線,稱為爐溫折線。需要注意的是:溫度曲線是回流過程中封裝或PCB板上的實際溫度變化,而爐溫折線是回流爐各溫區的溫度設置,前者是目的,后者是手段。“溫區-爐溫折線-溫度曲線”的相互關系如下圖所示:

工藝窗口與工藝窗口指數
工藝窗口(Process Window),通常用來描述工藝參數調整極限范圍或用戶規格范圍(USL-LSL),最大允許值與最小允許值之間的區域。
工藝窗口指數(Process Window Index, PWI),是衡量用戶確定的工藝極限范圍內工藝能力適應程度的指標,換句話說,就是使用工藝窗口的最大百分比,用于簡單說明工藝是否滿足技術規范的要求,其值基本上是Cp倒數的百分比。PWI越大,工藝穩定性越差,反之亦然。
溫度曲線解析
溫度曲線,根據功能一般可劃分為四個區:升溫區、保溫區、再流焊區和冷卻區,其中再流焊區為核心區。
溫度曲線,一般以預熱溫度、保溫時間、焊接峰值溫度和焊接時間來描述,關鍵參數如下:
· 預熱開始溫度Tsmin;
· 預熱結束溫度Tsmax;
· 焊接最低峰值溫度Tpmin;
· 焊接最高峰值溫度Tpmax;
· 保溫時間ts;
· 焊接時間tL;
· 焊接駐留時間Tp;
· 升溫速率v1&v2;
· 冷卻速率v3。
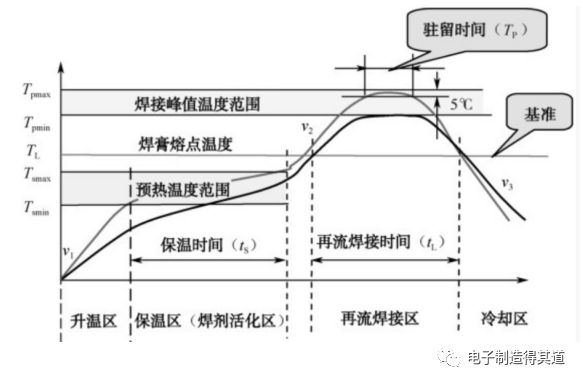
關鍵參數的設置原則
01 預熱
預熱的作用主要有三個:蒸發焊劑中的揮發性成分;減少焊接時PCBA各部位的溫度差;助焊劑活化。
預熱開始溫度(Tsmin),一般沒有特別的要求,通常比預熱結束溫度(Tsmax)低50℃左右;
預熱結束溫度(Tsmax)為焊膏熔點以下20~30℃,通常200℃左右。
保溫時間(ts),一般在2~3min。確保PCBA在進入再流焊階段前達到熱平衡。從經驗看,只要不超過5min,一般不會出現焊劑提前失效問題。
02 焊接峰值溫度
焊接峰值溫度,由于PCB上每種元件封裝的結構與尺寸不同,而且分布密度也不均勻,所以測試溫度曲線不是一根曲線,而是一組曲線。
溫度曲線的設計原則是所有元器件的焊接峰值溫度,既不能高于元件的最高耐熱溫度也不能低于焊接的最低溫度要求。通常比焊膏熔點高11~12℃并小于260℃(無鉛元器件),在此前提下我們希望焊接的溫度越低越好。
較高的溫度出現在熱容量比較小的元件上(如0402等),較低的溫度出現在熱容量較大的元件上(如BGA等)。
03 焊接時間
焊接時間主要取決于PCB的熱特性和元器件的封裝,只要能夠使所有焊點達到焊接溫度以及BGA焊錫球與熔融焊膏熔合均勻并達到熱平衡即可。
焊接的時間,對于一個普通的焊點而言3~5s足夠;對于一塊PCBA來說,需綜合考慮所有的焊點;同時,還必須考慮減少PCBA不同部位的溫度差以減少熱沖擊或熱變形。因此,PCBA的焊接與單點的焊接有本質的差別,焊接時間會大大延長。
不同溫度、時間下的BGA焊點的微觀結構
隨著溫度的升高,無鉛焊球中Ag3Sn、Cu6Sn5相會進一步細化,金屬間化合物(IMC)會變得持續生長。如果溫度過高,也會使BGA焊球塌落過度,影響可靠性。特別是那些帶有金屬散熱殼的BGA。
不同溫度、時間下形成的BGA焊點的形態取決于焊料與焊球的混合程度以及混合合金的表面張力,如果混合不均、表面張力不夠,就不會形成鼓形的焊點,甚至帶有硬過渡的外形。
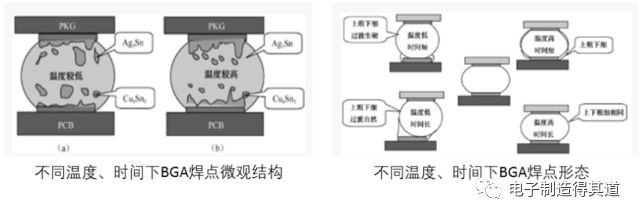
04 升溫速率(v1)
升溫速率(v1),主要影響焊膏溶劑的揮發,過高,容易引起焊錫膏飛濺,從而形成錫球。因此一般要求控制在1~2℃/s。
升溫速率(v2),是一個關鍵參數,對一些特定焊接缺陷有直接的影響,過高容易引發錫珠、立碑、偏斜和芯吸。一般要求盡可能的低,最好不要超過2℃/s。
05 冷卻速度
IPC/JEDEC-020C標準對業界能接受的冷卻速率做了規定,該標準將3-6℃作為冷卻速率的范圍。但這樣的規定實際上存在很大的風險,特別是焊接BGA器件時,如果冷卻速率達到4.5℃/s以上時,很可能導致焊點斷裂!
一般而言,較厚的塑封BGA需要慢速冷卻,甚至需要熱風慢冷,因為它是一個典型的雙層結構且容易吸潮。實際案例表明,如果冷卻速率小于等于2℃/s,就容易發生收縮斷裂了。
06 特定封裝的特別要求
BGA器件,焊接最低峰值溫度必須達到二次塌落所需要溫度(熔點+11~12℃);必須有足夠的焊接時間,以便BGA封裝體達到基本的熱平衡,避免BGA在嚴重變形狀態下焊接。下釁焊接時間比較長,這主要因為現在使用的BGA越來越大,必須有足夠的時間保證BGA焊點在封裝接近熱平衡條件下凝固。
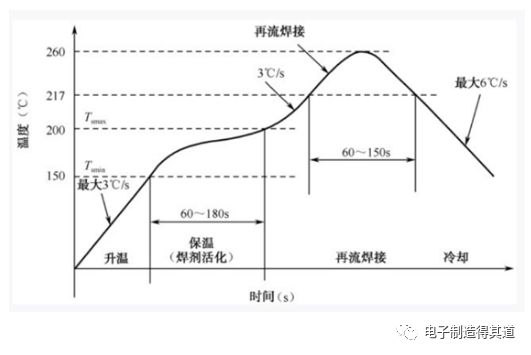
0201等微型片式元件,主要的焊接問題是立碑和葡萄球現象。
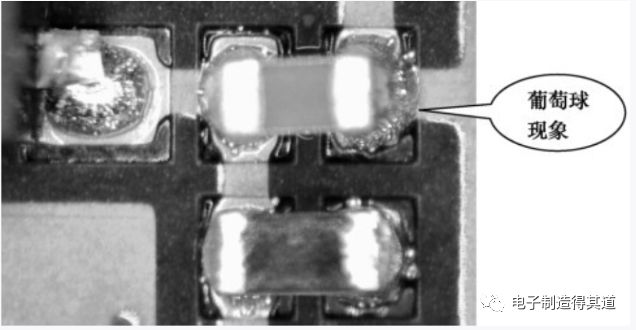
一個減少立碑現象的措施就是減小熔點以下10℃到熔點之間的升溫速率,如無鉛焊接工藝條件下,需要適當降低再流焊接溫度曲線上200~220℃區間的升溫速率。
葡萄球現象是無鉛、微焊盤焊接帶來的新問題。一般而言,焊盤尺寸小,相應印刷的焊膏也少。焊膏少,其含有的焊劑總量也隨之減少,去除氧化物的能力不足,很容易發生葡萄球現象。因此,在溫度曲線設置時需還要適當減少預熱的總時間,避免焊膏表面焊粉的過度氧化。
密間距器件,如0.4mmQFP容易橋連,要盡量減少熱坍塌現象的發生,這就需要減少高溫預熱階段的停留時間。
5 溫度曲線評價
如果需要對一個測試曲線進行較為客觀、準確的評價,需要多方面考慮。
與爐子的設置溫度聯系起來進行評價。因為設置溫度與焊接峰值的溫度差決定元件和PCB的變形和焊接應力,這通常比升溫速率或冷卻速率更好判斷。
· 與元件封裝聯系起來進行評價,特別是BGA的封裝結構聯系起來評價。因為不同封裝的BGA,其熱容量大小相差很大,熱變形過程也不同。
與工藝聯系起來看,比如采用的是有鉛工藝還是無鉛工藝,是Im-Sn還是HASL,不同的工藝條件,對溫度曲線的要求是不同的。
一般而言一個比較好的溫度曲線,應該具備:
PCBA上最大熱容量處與最小熱容量處在預熱結束時溫度匯交,也就是整板溫度達到熱平衡;
· 整板上最高峰值溫度滿足元件耐熱要求,最低峰值溫度符號焊點形成要求;
BGA封裝上的最高溫度與最低溫度之間不得有大于5℃的溫差存在,一般不允許超過7℃;
通過建立溫度曲線,首先按照PCBA的熱特性對其進行工藝性分類,以便對每類產品確定合適的溫度曲線;
基于我們關心的問題- 焊點的形成溫度、封裝的最高溫度以及溫度均勻性,應該選擇有代表性的封裝作為我們的分類條件,能夠反映PCBA上最高溫度、最低溫度以及BGA焊接質量的點作為測試點。
6 結尾
理論作指引,實踐出真知。本文雖然解析了再流焊溫度曲線及其工藝窗口的原理和評價原則。但對于具體產品溫度曲線的調節,每個溫區的溫度該增加或減少幾度,鏈速該增加或減少多少只有通過實操才能掌握,學習理論指引的方法論,同時多實踐、多體會、多思考,你就可以成為調節溫度曲線的行家里手。
深圳市福躍達電子科技有限公司
聯系人:周玉
電話:13828893597
座機:0755-29819639
傳真:0755-29672986
地址:廣東省深圳市龍華大浪街道高峰社區華榮路33號億康商務大廈A棟8058
